A gázfázisú epitaxia fémorganikus vegyületek
„Fémorganikus” - egy olyan vegyületcsoportot, amely fém-szén (szerves fémvegyület), vagy egy fém-oxigén-szén kötések (alkoxidok) és koordinációs vegyületeket a fémek szerves molekulák. Hosszat szobahőmérsékleten, akkor sósavval legtöbb folyadékot, bár néhány közülük még magas hőmérsékleten kemény-mi. Ezek az anyagok tipikusan nagy a gőznyomása és könnyen szállítható a reakciózónába vezetjük egy hordozó gáz, például hidrogén vagy hélium, a folyadék vagy a szilárd, amelyek szerepét a forrás.




A nőnek epitaxiális réteg A3 B5 vegyületek, beleértve a gallium-arzenid a gőzfázisból, három on-ibolee elterjedt módszer. Az első társul Execu-mations halogén vegyületet - a-kloridos eljárással. második - segítségével arzin (AsH3) és hidrogén-klorid (HC1) - klorid-hidrid módszerrel. a harmadik - a metalloorga-nikai vegyületek (MOC). Az utóbbi módszer, sőt, de egyfajta üvöltés-kémiai gőzfázisú (HPE ISO).
Használata klorid és a klorid-hidrid módszerek nem képesek növekedni tartalmazó vegyületek A1, például AICI3 reagál a falak a kvarc reaktor. Ezek a vegyületek a termesztett egy teljesítmény-fázisú epitaxia alkalmazásával metalloorganiche-ing vegyületek. Ez a technológia miatt az egyszerűség, a könnyű ellenőrzés és egyéb előnyök préselt kloridot HPE rendszer Ga-AsCl3 -H2. Ezt a módszert sikeresen alkalmazták az Ön számára, kapacitás- heterostructures GaAs-Alx Ga1-x néven.
A szabványos gázfázisú epitaxia eljárás, MOS forrás használatos fémorganikus Ga vegyületet trimethylgallium Ga (CH3) 3 vagy triethylgallium Ga (C 2H 5) 3. és források com Amint az arzén (AsH3). Ha a hagyományos termesztési HPE végezzük egy forró reaktorban, abban az esetben, HPE MOS elegendő csak a hő a szubsztrátum. A túltelítettség foka a gáz fázis nagyon nagy. Gőzfázisú epitaxia alkalmazásával metalloorga-nikai csatlakozások ideális heteroepitaxy.
Kémiai gallium-arzenid növekedési reakciót, például trimetil-gallium és az arzén-hidrid lehet írva a következő formában:
Ezeket a reakciókat hajtjuk végre 700 ° C-on a hidrogén jelenlétében. Hasonló reakciók termesztésére használt egyéb kettős-TION, terner és kvaterner vegyületek. Például, a vegyületek növelik Alx Ga1-x által leírt egyenlettel:
Ebben az esetben a atomi koncentrációja „x” van társítva alumínium-gében parciális nyomások trimetil gallium és trimetil-alumínium, a gázfázisban. Ebben az esetben, az összetétele a epitaxiális filmet közvetlenül aránya határozza meg a parciális nyomások trimetil gallium és trimetil-alumínium, a gázfázisban.
Egyszerűbb telepítés diagram HPE MOS ábrán látható. 2.4. termesztés eljárás magában előállítására egy szubsztrátumot (tisztítás és maratás), átöblitjük a rendszert hidrogénnel, fűtés a szubsztrát alkalmazásával mikrohullámú induktor közvetlenül felvitel és az azt követő hőkezelés.
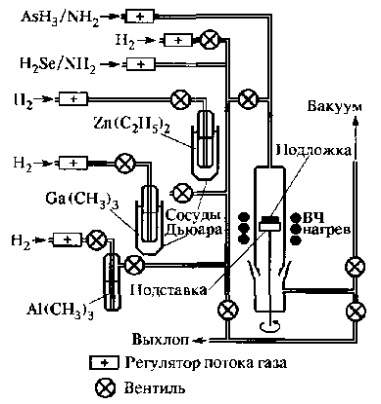
Ábra. 2.4. Készülék gőzfázisú epitaxia a gallium-arzenid struktúrák.
Egy adalékolatlan gallium-arzenid tenyésztettünk piro-litikus reakciójával trimethylgallium és arzin. Mindkét CPD-neniya át a reakciózónába útján vivőgáz - in-testes.
Hasonlóképpen szállított trimetil-aluminum AI (CH 3) 3. ha azt szeretnénk, hogy növekszik a Alx Ga1-x néven. Vezérlő nyomás-niyami különböző reagensek segítségével végezzük a gáz-raskhodome árok. Szubsztrát Raspaud-bontjuk al-ráta grafit bevont szilícium-karbid, amely PROTSES-se forog lerakódás javítására homogenitását inkrementális réteg.
A kristályosodás során epitaxia fémorganikus ko-egysége (MOS) hajtjuk végre, hogy az N-bázis kártya homogén keveréket a reagensek a hordozóval gázoknak egy fűtött Planchet Coy egy reaktorban hideg falakon. Használt a növekedés a félvezető filmek hidridek szobahőmérsékleten vannak gázok és szokásos alkalmazásuk a kis-to bavok a H2. Ezek a fémorganikus és hidrid komponenseket összekeverjük a gázfázisban és pirolizált N2 áramban. Az eredmények szerint, pirolízis reakció, amikor a gáz halmazállapotú vegyület bomlanak követően a komponenseket egy forró felületre, így egy szilárd-edik csapadék képződik stabil, szilárd félvezető-Union szója. a pirolízis hőmérséklet 600-800 ° C-on fűtés a hordozó és a növekvő film tipikusan létrehoz egy erős rádiós óra - frekvencia generátor frekvenciája körülbelül 450 kHz. Pirolízis prois-sétál nyitott reaktorban légköri vagy csökkentett (
70 Hgmm. v.) nyomáson.
Vannak reaktorok, amelyekben az áramlás a gázelegyet merőleges a hordozó felületén (általában ez reaktorok ver-tikalnogo típus), és a reaktorok, amelyekben az áramlás a gázkeverék DVI-zhetsya felülete mentén, vagy egy kis szögben hozzá (a szokásos, de ez a horizontális típusú reaktorok) .
Közel a növekedési felületet található egy átmenetifém-domént, amelyben a gázkeverék paraméterek változnak simán jellemző értékeket a konvekciós régió, hogy bizonyos értékek jellemző a felületi réteg. Ez az átmenet régió nevezzük a határréteg. Amikor az áramlás irányát felülete mentén a vastagsága körülbelül 4 mm, és a merőleges irány a szubsztrátum 20 mm. Belül Mayhem átnyúló-réteg hőmérsékletét a gázkeverék és annak összetétele függ a távolság a növekedési felületen. A konvekciós gáz tempera-utazási kevésbé hőmérséklet-emelkedés és a gázfázis összetételét nem én-nyaetsya. Sok esetben, az elektromos és krisztallográfiai tulajdonságai a kapott rétegek jellemzőitől függ a határ menti-láb réteg. Többrétegű, multi-epitaxiális szerkezet lehet termesztett egymás után egyetlen növekedési ciklus. Példa függőleges típusú reaktor beszerzése anyagok mellett ma-A3 ábrán látható B5 kép. 2.4.
Dopping a növekvő epitaxiális réteget bevezetésével végezzük gázáram megfelelő reagenssel. Doppingelemző A3 B5 vegyületek p-típusú szennyeződések képezik általában egy ispol'uet-fémorganikus reagensek: bistsiklopentadienilmagny és dietil-cinkből, és a dopping n-típusú ispol'uet alkotnak hidrid-H2 Se és SiH4. Fémorganikus reagensek könnyen bomlik a növekedési hőmérséklet, így az áramlás a szennyező-még a növekvő rétegben a diffúzió korlátozza a Frontier-edik réteg és a felületi kinetikája. Egy kis hányada szennyeződések ömlik a növekvő rétegben, és a legtöbb diffúz-kéz a gázfázisú. Ahol a szennyező nívó független a növekedés üteme a réteg, de csökken exponenciálisan növekszik a-mérséklet és a növelésével növekszik parciális nyomása a arzin AsH3. Hatásosság szilícium dopping korlátozott ter-mohimiey használt hidridek. A bomlás sebessége a felületükön kicsi, és egy nagy részét a szennyeződések, kialakítva a felső felület tartalmazza a növekvő rétegben. Ebben az esetben, a szennyező nívó fordítottan arányos a növekedési ráta és a kosár-exponenciálisan növekvő hőmérsékleten megolvasztjuk. Szint krém-niem dopping nem függ a parciális nyomása AsH3.
A növekedési ráta által meghatározott mértékben keresztül diffundálnak a Mayhem-határréteg-komponenseket tartalmazó elemei a harmadik csoport. A elemei az ötödik csoport van az egyensúlyt a gáz és a szilárd fázisok. Feletti hőmérsékleten 800 ° K, a hőmérséklet-emelkedés sebessége független önálló növekedési ráta és nyomástartó CIÓ arzin, amelyek, annak érdekében, hogy sima rétegek SZEZON minőségű típusú, legalább egy nagyságrenddel nagyobb, mint a nyomás alatti alkatrészeket, amely tartalmaz egy tagot a harmadik csoport. Uwe-lichenie gáz áramlási sebességének gyorsítja a növekedést az epitaxiális réteg. A növekedés a gázáram a parciális nyomása a reagensek minden esetben növeli a növekedési ráta.
A növekedés a többrétegű szerkezetek végzik megváltoztatásával gázatmoszféra a reaktorban. A sebesség, amellyel végez Xia ilyen változás mennyiségétől függ az áramlás és a geometria a rea-tórusz. Nagy sebességnél a helyettesítő gáz lehet végezni az áramlási elég gyorsan és fogadására így éles geteropereho-dy. Az ehhez szükséges idő csere határozza meg áram erősségét. Ezért, élességét határok kapcsolódik a hamarosan-Stu és a növekedés, mint a növekedési vegyületek A3 B5. Ez függ a koncentráció a reagens gázt átáramló tartalmazó reaktorba-vezető elemet a harmadik csoport. Kísérleti adatok a szuperrács GaAs- Alx Ga1-X néven lehet következtetni, hogy ha az automatizált rendszer esetén növekedési CPNS ÁFA szuperrács rétegek vastagsága 1,5 nm (bizonyos esetekben-ek, hogy 0,7 nm), a nagy szerkezeti tökéletessége. Összetételének megváltozása következik be szinte a vastagsága egy adott monoréteg. Ahhoz, hogy gyorsan változik a gáz fázis összetétele a növekvő felület a reaktor tervezési igényel optimalizálás, hogy megszüntesse időben terjedő koncentráció előtt a gázáram miatt különböző-TION a diffúziós folyamatok.
Általában, a növekedési ütem megegyezik ≈ 0,1 m / min. Hod sósav nehézségi MOS HPE módszer zagryaz-nenie növekvő réteg szén-genus, amelynek forrása a metalloorganiche-mechanikai kapcsolatot. Ez nekem-it, a minősége a rétegek hasonló minőségű elért Use-Vania más típusú epitaxiális technológia.
Preimuschest fő PTO HPE-MOS van viszonylagos egyszerűsége lehetőségét növekvő és szilárd oldatok a Alx Ga1-X néven. Van egy változata ezt a módszert, tudván, jelentősen megnöveli a képességek - HPE AIJ NYM csökkentett nyomás a reaktorban. A tény az, hogy hozzon létre eszközökön sokochastotnoy-elektronika és opto-elektronikai egyre inkább IP-használatra szerkezete, beleértve a multi-layer tartalmazó szubmikronos és nanométer nagyságrendű réteg egykristály szilícium és gallium-arzenid, és más vegyületek A3 B5. Sok SLE-teák fontos, hogy a rétegek vastagsága szigorúan meghatározott; más szavakkal, az szükséges, hogy a határréteg-szubsztrátot, vagy a réteg-réteg volt éles, és a vastagsága az átmeneti réteg, azzal jellemezve, összetételének megváltozása vagy a dópoló anyag koncentrációja-B nem haladja meg a 10 nm-nél. Mindazonáltal a hagyományos MOS HPE és HPE nem tud éles heteroboundaries. Spreading dopping profil a heterojunction általában az eredménye a szennyező diffúziós a szilárd fázisban, vagy a „self-szennyezéssel”, de leggyakrabban az oka, hogy helyettesíti a gázkeverék a reaktorban igényel véges időt.
Csökkentése a nyomást a gázelegy vyrashivanii vegyületek A3 B5 típusú MOS HPE módszer hatékonyan szabályozza mind a koncentrációgradiens a szennyeződések és gradiens változások az exponáló fő komponenseket. Spreading profil állapot változás szigetek alacsony nyomás a reaktorban lehet korlátozni vagy leállításával a növekedési folyamat idején létesítmény egy új áramlás a gázkeverék szükséges növekvő a következő réteg, vagy növeljük az áramlási sebességet, amely lehetővé teszi a csere a gázkeverék gyorsabb. Az utóbbi körülmény fontos karaktert Stick MOS HPE módszer alacsony nyomással.
Egy másik jellemzője az eljárás MOS HPE csökkentett nyomáson áll az a tény, hogy összehasonlítva a hagyományos kiviteli alakjai tehnologo-ology HPE és HPE MOS folyamat növénytermesztést végeznek jelentős sebességgel, de nagyobb a gáz áramlását. Sebességének növelése a gáz-áramlás elve lehetővé teszi a megszerzése egyenletesebb rétegben, de jobb, hogy csökkentse a nyomást a reaktorban, mint egyszerűen növeljük az áramlási sebességet légköri nyomáson. Valóban-tény, az utóbbi esetben, növeli az áramlás a hideg gáz tömegének vezetne szubsztrát hűtés, míg a csökkentett nyomású prefektúra lehetséges, hogy növelje a gáz áramlási sebessége megváltoztatása nélkül tömegáram és a szubsztrátum hőmérsékletét. Ez az, amikor, javulásához vezet az egyenletesség a növekvő rétegeket.
HPE MOS technológia alacsony nyomás a reaktorban-ren- delkeznek termesztésre kifejlesztett szilícium és GaAs; akkor ez a módszer kezdett termesztésére használt InP, (Gaál) As, GalnAsP - használt anyagok mikro- és nanoelektronika és optoelektronikai. Amikor növekvő GaAs, InP és (Gaál) Mivel ezek Me-Todd találtuk, hogy az áramlás a parazita reakciók a gáz-keveréket üvöltve miatt a csökkentett nyomás nagymértékben behatárolt. Ez jelentősen csökkenti a befolyása a önadalékolásos, amely lehetővé teszi a töltés élesebb profilokat adalék anyag koncentrációját a határait a réteg-réteg és a réteg-szubsztrát felületen.
HPE MOS csökkentett nyomás a reaktorban a Com-pared molekuláris epitaxia (MBE) egyszerűbb és termelékenyebb, versenyez sikeresen közelmúltban. Ez a módszer jött létre:
- A heterostructure GaAs / GaAlAs és térvezérlésű tranzisztorok tengelyeik nova szelektív dopping és nagy elektron mobilitás-tron a kétdimenziós elektron gáz;
- injekció lézerek alapján heterostructures Gaál / GaAsAs kvantumforrás;
- nnzhektsnonnye lézerek hullámhosszon működtetve 1,3 mikron egy nagyon alacsony küszöböt áramok;
- szerkezete (GAIN) Mivel / InP kvantum kutak egy sor és mtsai.
HPE Módszer MOS csökkentett nyomáson a reaktorba a MBE módszer lehetővé teszi, hogy kapjunk egy nagyon éles heterojunctions. Hod Nako kell jegyezni, hogy a heterostructure GaAs / (Gaál) As-sugárzás a hordozó mobilitási alacsonyabb volt, mint az azonos szerkezetű túrák által termesztett MBE.
MBE és gázfázisú epitaxia a MOS jó todami Me-művelési rendszer szuperrácsok a GaAs-Alx Ga1-X néven. A technológiai folyamat a kémiai gőzfázisú MOS reprodukálható nagy léptékben, és ennek eredményeként lehet egy félig-Chit epitaxiális struktúrák nagy területen. Így mo-gut elérendő magas növekedési ráta megfelelő iparági követelményeket tömegtermelése pit-csömör. MBE valószínűleg uralni a alapkutatás kvantum-dimenziós szerkezetek, és gázfázisú epitak-Sia a MOS - a tömegtermelés eszközök és a kutatás.
Nyomásának csökkentésével a gázkeverék növekedése során a vegyületek hatékonyan ellenőrizni mind a gradiens összetételének változási szennyeződések és gradiens változása az összetétel alapvető elemek. A csökkentett nyomáson gáz-halmazállapotú keverék is korlátozza az áramlás a káros reakciók, a gázkeverék. Csökkentett nyomáson, a tenyésztési eljárás ve létezik sokkal nagyobb gázáramot. Elvett a gáznemű áramlási sebesség lényegében lehetővé teszi, hogy több homogén réteg. Csökkentett nyomáson, van egy kosár-lehetőséget, hogy növeljék a sebességet a gázáram növelése nélkül on-folyó hideg gáz tömegét. Az áramlási sebességet növelve körülmények között légköri nyomás-Rep vezetne szubsztrát hűtés.